BGA(Ball Grid Array)作为现代电子产品中常见的封装形式,其焊接质量直接影响着产品的可靠性。X射线检测技术作为一种无损检测方法,能够有效地评估BGA焊点的质量状况。通过先进的,我们可以清晰地观察到焊点内部结构,识别各类潜在的质量问题。
焊点缺陷类型分析
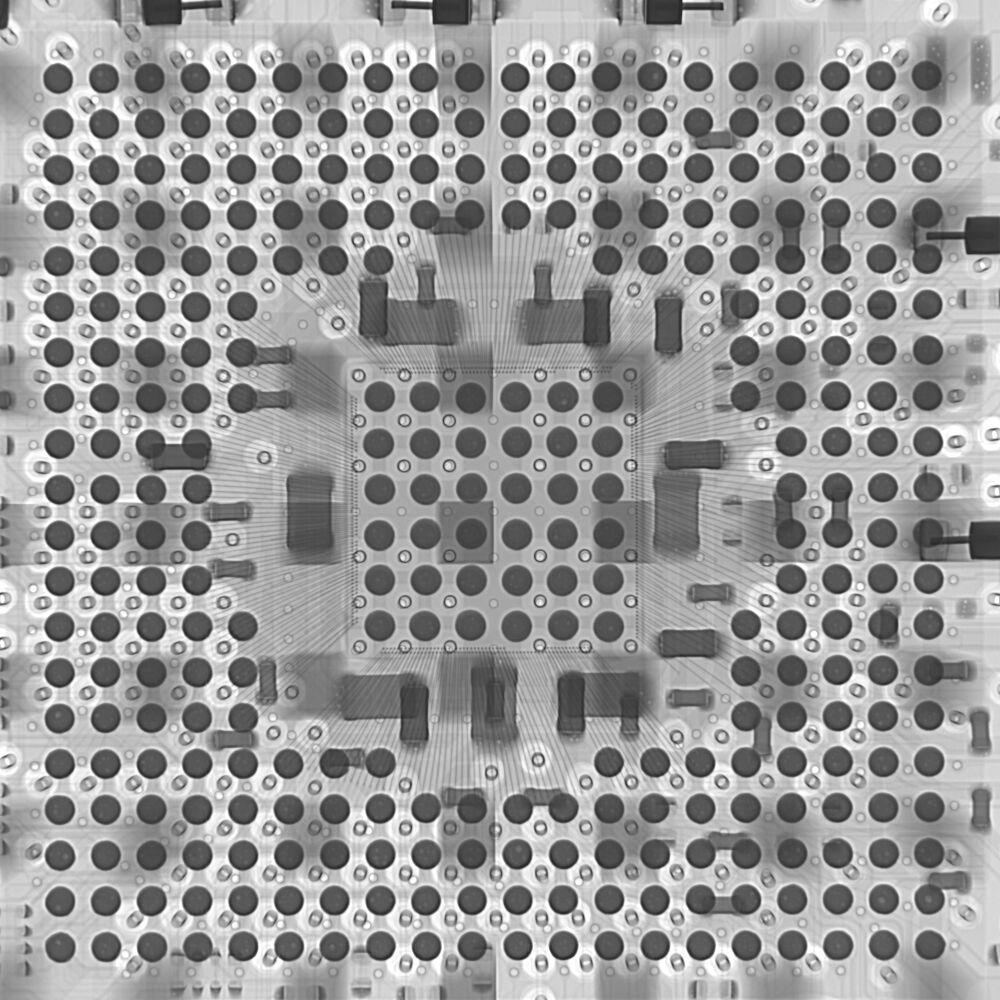
在BGA焊接过程中,常见的缺陷包括:
空洞(Void):,过多或过大的空洞会严重影响焊点强度
焊料外溢:过度回流导致焊料沿着焊盘蔓延至导线
焊球大小不一:回流控制不当导致焊球尺寸差异明显
焊接不良:表现为焊点形状不规则或连接不完整
X射线检测技术优势
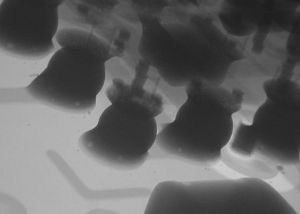
现代X射线检测系统具备以下关键特性:
多角度观察能力,可实现斜角和复合角度检测
高分辨率成像,能够清晰显示焊点内部结构
实时检测功能,支持在线品质监控
自动化缺陷识别,提高检测效率和准确性
检测要点与建议
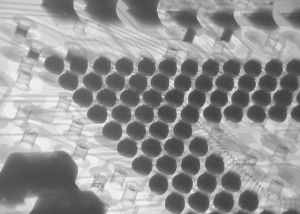
进行BGA焊点检测时,需要重点关注:
焊球形状的一致性评估
空洞率的测量与控制
焊点与焊盘的连接情况
焊料分布的均匀性









