BGA焊点的X光检测 空洞缺陷的精准定量与质量控制
BGA(Ball Grid Array,球栅阵列)作为一种主流的高密度封装技术,已被广泛应用于各类高端芯片与微处理器中。其最大的特点在于,芯片引脚摒弃了传统的四周引出方式,而是以圆形或柱状的焊球按阵列形式密集分布在芯片底部。这种设计极大地提高了I/O引脚数量,缩短了信号传输路径,改善了高频性能和散热效果。
然而,创新的结构也带来了严峻的品控挑战:一旦芯片焊接到PCBA(印制电路板)上,所有的焊点都被隐藏在芯片腹底,传统的光学检测(AOI)或肉眼根本无法观测其内部焊接状态。为了确保出厂产品的绝对可靠性,企业通常必须依赖专业的 X光检测 设备进行无损透视,以窥探和评估隐蔽焊点的真实质量。
一、 BGA焊点隐蔽缺陷的头号难题:空洞(Voiding)
在BGA的SMT贴片与回流焊工艺中,常见的焊接缺陷包括空洞、虚焊(冷焊)、连锡(短路)以及焊点尺寸异常等。在这其中,空洞缺陷(Voiding)是最为普遍且最令工程师头疼的隐患。
空洞是如何产生的? 在高温回流焊接过程中,焊膏中的助焊剂等有机物会发生剧烈反应并挥发成气体。如果升温曲线设置不当或焊料润湿不良,这些气体被包裹在熔融的液态锡内部,来不及逸出,冷却固化后就会在焊点内部形成气泡,即我们所说的“空洞”。
空洞的致命影响: 空洞的存在减少了焊料的实际连接截面积,这不仅会直接导致焊点机械抗剪切强度的断崖式下降,还会严重阻碍芯片的导热与导电性能。在长期的高低温热循环或机械振动环境下,空洞边缘极易产生应力集中,进而诱发微裂纹,最终导致整个焊点断裂、信号传输失效。
二、 严苛的行业防线:BGA空洞缺陷的质量判定标准
并非所有空洞都会导致产品报废,适度的微小空洞在当前的工艺条件下是难以完全绝迹的。国际通用的IPC质量验收标准对BGA焊球内部的空洞尺寸给出了严格的量化界限:
【可接受区间】空洞面积占焊球总面积的 10% ~ 25%: 此时的焊接质量在力学与电学上尚可接受,不会立即引发失效。但对于高可靠性产品,这已经敲响了警钟,生产制造端应立即复盘并改进回流焊温度曲线或更换焊膏,以减少气泡产生。
【严重缺陷】单一空洞面积超过焊球总面积的 25%: 如此巨大的空洞将成为焊点的“致命软肋”,对产品的长期电学性能和力学可靠性构成重大隐患,必须判定为不合格品(缺陷)。
【累加超标】多个空洞总面积超过焊球总面积的 20%: 若同一个焊点内出现多个离散的小空洞(即“蜂窝状”空洞),哪怕单个尺寸不大,但只要其面积总和突破20%的红线,同样被视为严重不合格,极易引发早期断裂失效。
由此可见,决定产品是合格出货还是面临退货返工的核心,在于能否极为精确地计算出“空洞面积”与“焊球总面积”的比值。
三、 BGA焊点的X射线(X-Ray)穿透检测原理
针对不可见的BGA阵列,X射线提供了完美的无损检测方案。在检测过程中,微焦点X射线源发射出高能射线,向下穿透PCBA板材、铜焊盘以及内部的锡球。穿透后的射线被底部的平板探测器或图像增强器接收,并转换为超高分辨率的可见灰阶图像。
由于焊点(金属锡/铅/银合金)密度极高,会吸收大量的X射线,在图像上呈现为深色(黑色或暗灰);而空洞内部是气体,密度极低,射线几乎无阻碍穿透,在图像上便呈现出明亮的白色斑块。X射线源的焦斑尺寸越小,放大倍率越高,所成图像的检测精度和边缘灵敏度就越强,甚至能发现微米级(μm)的微小气泡。
 图1:采用回流焊焊接的塑封BGA芯片局部X射线图像。深色焊球内部明亮的白色圆形区域,即为清晰可见的气泡空洞。
图1:采用回流焊焊接的塑封BGA芯片局部X射线图像。深色焊球内部明亮的白色圆形区域,即为清晰可见的气泡空洞。四、 告别肉眼估算:BGA焊点空洞缺陷的智能定量分析
传统的检测往往依赖作业员的肉眼经验去“估算”气泡占比,这不仅效率低下,而且误判、漏判率极高,根本无法满足现代智造对品质数据化的要求。如今,配合专业的X射线检测软件,我们可以实现对BGA空洞的智能识别与精准定量分析。
如下图所示,我们对上述X光图像中的9个典型BGA焊点进行了高级图像算法处理,精准执行了“焊点区域”与“空洞区域”的边界提取,并以高亮色彩标记在原始图像上。
 图2:BGA焊点图像空洞区域自动提取结果。蓝色轮廓精准锁定了焊球边缘,红色/绿色区域则成功圈定了内部的各个空洞。
图2:BGA焊点图像空洞区域自动提取结果。蓝色轮廓精准锁定了焊球边缘,红色/绿色区域则成功圈定了内部的各个空洞。在这个智能处理环节中:
每个BGA焊点都被软件算法完整地从复杂的电路板背景中分割出来;
焊点内部无论是中心大空洞,还是边缘的微小散落气泡,均被无死角提取;
系统按照列方向坐标的取值顺序,对每一个焊点进行了唯一的数字编号(如上图1至9),确保数据可追溯。
在完成精确的图像区域提取后,系统会自动统计出每个BGA焊点轮廓内的总像素个数,以及所有空洞区域的像素个数。通过像素级的比对换算,即可得出BGA焊点的等效面积和空洞的等效面积,最终一键输出客观、科学、不可篡改的“面积占比(空洞率)”。
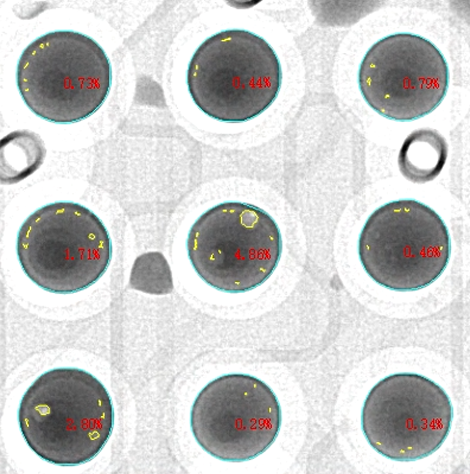 图3:系统自动生成的BGA焊点空洞率定量分析报告。各焊球的直径、总面积、空洞面积及最终的“空洞百分比”一目了然,超标项可自动警报。
图3:系统自动生成的BGA焊点空洞率定量分析报告。各焊球的直径、总面积、空洞面积及最终的“空洞百分比”一目了然,超标项可自动警报。在电子产品日益追求轻薄化、高频化、长寿命的今天,BGA焊接质量直接决定了整机的可靠性。通过引入高分辨率微焦点X光检测设备与智能空洞分析算法,企业不仅能拦截不良品流向市场,更能通过精确的数据反馈,逆向指导并优化前端的SMT生产工艺,真正实现降本增效,赢得市场与客户的深度信赖。









